一种倒装LED芯片及其制备方法与流程
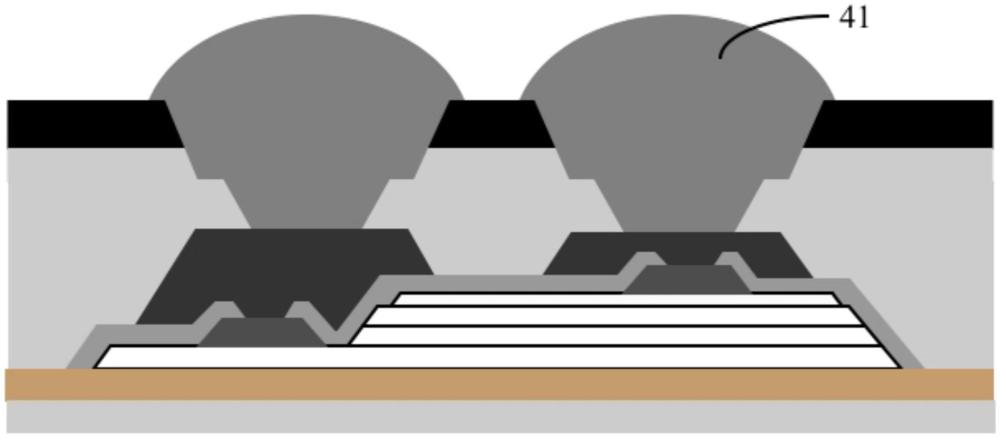
本发明涉及半导体,尤其涉及一种倒装led芯片及其制备方法。
背景技术:
1、当前,led芯片结构主要有垂直结构、正装结构和倒装结构三大类。其中倒装led芯片由于其优越的散热性能、紧凑的结构设计和出色的光学性能,成为目前主流的led芯片发展方向。不同于正装led芯片正面出光的设计,倒装led芯片光从背面出射,从而可以避免金属电极遮挡发光面的情况,有效增大发光面积,因此同面积的倒装led芯片发光亮度往往高于正装芯片。
2、虽然得益于有效发光面积的增大,但是倒装led芯片亮度的提升幅度却不及人们的预期。其中部分原因是多量子阱层的辐射光需要穿过较厚的n-gan外延层、图形化的蓝宝石衬底层才能出射,而gan材料本身透光率不高且会吸收蓝光波段的可见光产生二次辐射,造成出光亮度的降低。尽管在外延生长时,可以通过降低n-gan层的厚度来增加透射率,但是会导致外延质量大幅降低,总发光效率不升反降。这是因为在外延生长时,靠近蓝宝石衬底一侧的大部分n-gan层都充当外延缓冲层的作用,用于抵消蓝宝石衬底的晶格应力,贸然降低n-gan层的厚度会使多量子阱层的外延质量降低,从而导致led器件发光亮度降低。因此,如何进一步提高倒装led芯片的亮度成为当前的技术难题。
技术实现思路
1、本发明所要解决的技术问题在于,提供一种倒装led芯片的制备方法,通过对led芯片进行衬底转移及第一半导体层减薄,减少对出射光线的阻挡,从而提高发光效率。
2、本发明还要解决的技术问题在于,提供一种倒装led芯片,发光效率高。
3、为了解决上述问题,本发明公开了一种倒装led芯片的制备方法,包括以下步骤:
4、(1)提供外延片,所述外延片包括衬底及依次沉积在所述衬底上的第一半导体层、多量子阱层和第二半导体层;
5、(2)对所述外延片进行刻蚀,得到暴露第一半导体层的mesa台阶;
6、(3)在mesa台阶上形成第一电极,在第二半导体层上形成电流扩展层和第二电极;
7、(4)沉积反射层并开孔暴露第一电极和第二电极,分别在第一电极和第二电极上形成第一焊盘和第二焊盘,得到led芯片;
8、(5)在led芯片表面制备第一键合层并开孔,暴露第一焊盘和第二焊盘;
9、(6)提供带有第二键合层的基板,并通过第一键合层和第二键合层将基板与led芯片键合;
10、(7)剥离所述衬底并将所述第一半导体层减薄;
11、(8)在减薄后的第一半导体层上沉积出光层;
12、(9)将所述基板减薄并开孔,暴露第一焊盘和第二焊盘;
13、(10)在基板表面的孔洞内填充锡膏,并与第一焊盘和第二焊盘形成欧姆接触,得到倒装led芯片。
14、作为上述技术方案的改进,减薄后的第一半导体层的厚度为1μm~3μm。
15、作为上述技术方案的改进,步骤(7)中,采用机械研磨和化学机械抛光对第一半导体层进行减薄;
16、所述机械研磨的研磨压力为1kpa~5kpa,研磨盘转速为40r/min~80r/min,研磨液中磨料的平均粒径为1μm~10μm,机械研磨后,所述第一半导体层的表面粗糙度为0.1μm~5μm;
17、所述化学机械抛光的抛光压力为5kpa~12kpa,抛光盘转速为60r/min~120r/min,抛光液的ph为9~12,抛光液中磨料的平均粒径为50nm~70nm,化学机械抛光后,所述第一半导体层的表面粗糙度为0.5nm~5nm。
18、作为上述技术方案的改进,所述机械研磨包括第一次机械研磨和第二次机械研磨;
19、所述第一次机械研磨的研磨压力为1kpa~5kpa,研磨盘转速为40r/min~80r/min,研磨液中磨料的平均粒径为5μm~10μm,第一次机械研磨后,所述第一半导体层的厚度减薄30%~50%,表面粗糙度为1μm~5μm;
20、所述第二次机械研磨的研磨压力为1kpa~5kpa,研磨盘转速为40r/min~80r/min,研磨液中磨料的平均粒径为1μm~5μm,第二次机械研磨后,所述第一半导体层的表面粗糙度为0.1μm~1μm。
21、作为上述技术方案的改进,将所述第一半导体层减薄后,清洗所述第一半导体层。
22、作为上述技术方案的改进,所述出光层的材料包括al2o3、sio2、si3n4、mgf2、tio2和ti2o5中的一种或多种;
23、所述出光层的厚度为50nm~1200nm。
24、作为上述技术方案的改进,所述出光层包括依次沉积的al2o3层和sio2层,al2o3层和sio2层的厚度均为30nm~500nm。
25、作为上述技术方案的改进,还包括对基板表面进行表面处理,所述表面处理包括氧化处理和/或蒸镀绝缘层。
26、作为上述技术方案的改进,所述led芯片与所述基板的键合方式为直接键合或胶键合。
27、相应的,本发明还公开了一种倒装led芯片,所述倒装led采用上述的倒装led芯片的制备方法制得。
28、实施本发明,具有如下有益效果:
29、1、本发明提供的倒装led芯片的制备方法,将衬底剥离后对第一半导体层进行减薄,降低衬底和第一半导体层对出射光线的阻挡和吸收,制得的倒装led芯片的发光效率高,并且制备方法简单、高效。
30、2、本发明提供的倒装led芯片的制备方法,对第一半导体层进行机械研磨和化学机械抛光,对第一半导体层的损伤小,研磨、抛光精度高,减薄时间控制在5h以内,减薄后第一半导体层的表面粗糙度小于5nm。
31、3、本发明提供的倒装led芯片的制备方法,在减薄后的第一半导体层上设置出光层,出光层材料的折射率小于第一半导体层材料的折射率,从而减少全反射,提高芯片的出光效率。
技术特征:
1.一种倒装led芯片的制备方法,其特征在于,包括以下步骤:
2.如权利要求1所述的倒装led芯片的制备方法,其特征在于,减薄后的第一半导体层的厚度为1μm~3μm。
3.如权利要求1所述的倒装led芯片的制备方法,其特征在于,步骤(7)中,采用机械研磨和化学机械抛光对第一半导体层进行减薄;
4.如权利要求3所述的倒装led芯片的制备方法,其特征在于,所述机械研磨包括第一次机械研磨和第二次机械研磨;
5.如权利要求1所述的倒装led芯片的制备方法,其特征在于,将所述第一半导体层减薄后,清洗所述第一半导体层。
6.如权利要求1所述的倒装led芯片的制备方法,其特征在于,所述出光层的材料包括al2o3、sio2、si3n4、mgf2、tio2和ti2o5中的一种或多种;
7.如权利要求6所述的倒装led芯片的制备方法,其特征在于,所述出光层包括依次沉积的al2o3层和sio2层,al2o3层和sio2层的厚度均为30nm~500nm。
8.如权利要求1所述的倒装led芯片的制备方法,其特征在于,还包括对基板表面进行表面处理,所述表面处理包括氧化处理和/或蒸镀绝缘层。
9.如权利要求1所述的倒装led芯片的制备方法,其特征在于,所述led芯片与所述基板的键合方式为直接键合或胶键合。
10.一种倒装led芯片,其特征在于,所述倒装led采用如权利要求1~9任一项所述的倒装led芯片的制备方法制得。
技术总结
本发明公开了一种倒装LED芯片及其制备方法,所述制备方法包括以下步骤:提供外延片;在外延片上形成电流扩展层、第一电极和第二电极;沉积反射层并开孔暴露第一电极和第二电极,分别在第一电极和第二电极上形成第一焊盘和第二焊盘,得到LED芯片;将基板与LED芯片键合;剥离LED芯片的衬底并将第一半导体层减薄;在减薄后的第一半导体层上沉积出光层;在基板上开孔并暴露第一焊盘和第二焊盘,刷锡焊接形成欧姆接触,得到倒装LED芯片。实施本发明,可以大幅提高倒装LED芯片的透光率,从而提高器件的发光亮度。
技术研发人员:茹浩,吴晓霞,鲁洋,胡加辉,金从龙
受保护的技术使用者:江西兆驰半导体有限公司
技术研发日:
技术公布日:2024/11/14
技术研发人员:茹浩,吴晓霞,鲁洋,胡加辉,金从龙
技术所有人:江西兆驰半导体有限公司
备 注:该技术已申请专利,仅供学习研究,如用于商业用途,请联系技术所有人。
声 明 :此信息收集于网络,如果你是此专利的发明人不想本网站收录此信息请联系我们,我们会在第一时间删除
